一颗芯片的“隐形守护者”:晶圆切割液如何让芯片制造更精密、更高效
随着科技的飞速发展,消费电子产品性能的每一次飞跃,都离不开芯片制造工艺的持续突破,而其中芯片能否从晶圆上完美分离也是很重要的一步,是怎么从一整片圆圆的硅片上“切”出来的?如何高效切割?那我们就需要一个帮手,它就是晶圆切割液。

晶圆切割,芯片诞生的“成人礼”
芯片制造的前半段——光刻、刻蚀、薄膜沉积——在无数人的科普中被反复提及,但鲜有人注意到,芯片完成前半段加工之后,还要经历一道关键工序:晶圆切割。简单来说,晶圆切割就是在一片已经布满数千甚至数万颗芯片的硅晶圆上,沿切割道将它们一颗颗分离成独立的芯片,以便后续进行封装和测试。这道工序,被称为芯片的“成人礼”。
目前主流的切割工艺包括刀片切割和激光切割两大类。刀片切割使用最广泛,约占据80%的市场份额,特别适合厚度大于100微米的晶圆切割,具备效率高、成本低、使用寿命长的优点。而激光切割则是非接触式加工,精度更高,主要适用于超薄晶圆和先进封装领域。无论采用哪种切割方式,切割过程中都会产生大量热量、摩擦和碎屑——这时,晶圆切割液就要登场了。
什么是晶圆切割液?
晶圆切割液是一种用于半导体制造过程中的化学液体,主要用于晶圆切割时辅助冷却、润滑和清洗。它由聚乙二醇、表面活性剂、螯合剂、有机醇、缓蚀剂等多种功能成分配制而成,经过精确配比后,能实现多重作用协同。从形态上看,切割液通常以浓缩液的形式提供,现场用去离子水按比例稀释后使用。
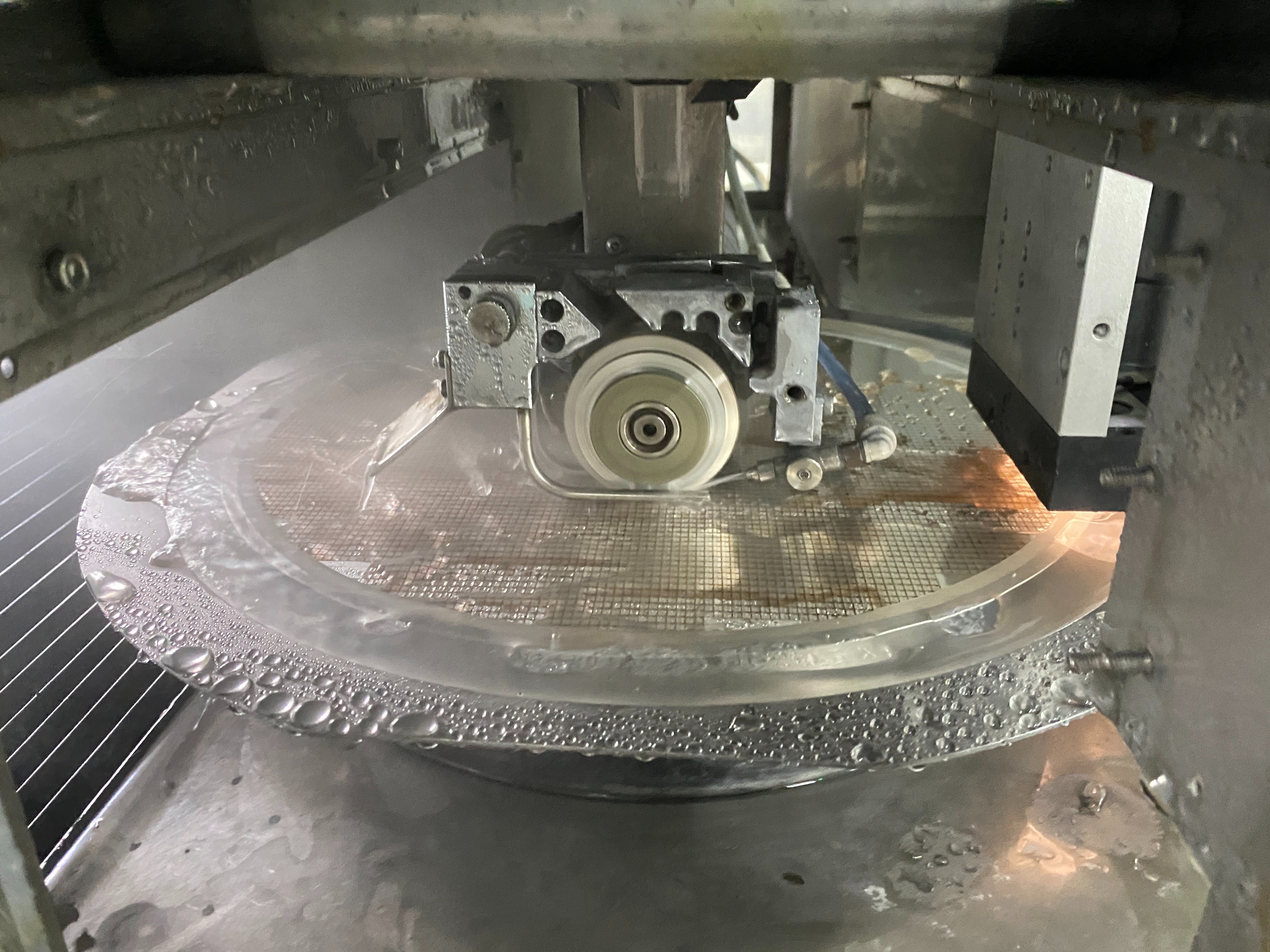
图片来源于网络
晶圆切割液的四大核心功能
图片来源AI
①冷却降温:切割时,刀片高速旋转与晶圆剧烈摩擦,瞬时温度可达400℃。切割液通过吸收并带走热量,有效防止晶圆因过热而发生热损伤或变形。没有它,芯片很可能会在切割过程中直接“烧坏”。
②润滑减摩: 切割液在刀片与晶圆表面之间形成一层润滑膜,显著降低摩擦力和切割阻力,从而减少崩边、裂纹等缺陷,延长切割刀片的使用寿命。对于硬脆材料如碳化硅、氮化镓来说,润滑效果直接决定了切割良率。数据显示,传统工艺下硬脆材料划片的崩边缺陷率可达5%至8%,部分高端芯片甚至因缺陷超标导致整批晶圆报废。优质的切割液能把崩边控制在5微米以内,显著提升良率。
③清洗排屑: 切割过程会产生大量硅尘颗粒和碎屑,这些杂质如果不及时清除,就会附着在芯片表面,特别是焊盘区域——这里尺寸只有芯片的几十分之一,更难清洗干净。切割液能有效悬浮和冲走这些杂质,保持切割道畅通无阻。
④防腐蚀与抗静电。 切割液还兼具防腐蚀作用,能保护刀片和基板免受损伤;同时抑制静电积累,防止静电放电对芯片内部电路造成不可逆的损坏。有些产品甚至具备抗菌功能,能防止微生物在设备管道中滋生。
简单来说,切割液的工作原理可以这样理解:它像“手术中的冲洗液”一样注入切割区域,利用其出色的润湿性和分散性,将摩擦热量、硅粉碎屑和静电等“捣乱分子”一并带走,让切割过程更顺畅、更精准。
水溶性VS油性:怎么选?
按照成分,晶圆切割液主要分为水溶性(水基)和油性(油基)两大类。
油性切割液以矿物油为主要成分,润滑性能优异,但本身易燃,清洗时需要含氟有机溶剂,对环境和人体都有较大危害,目前在硅片切割领域已基本不再使用。
选择哪种切割液,还要看具体场景。对于脆性较大的材料,润滑性好的切割液更适用;对于高精度、低温升的切割要求,水溶性或半合成切割液则更具优势。此外,环保合规性和设备兼容性也是重要的考量因素。
小材料背后的“大趋势”——国产化替代
晶圆切割液虽然是一种耗材,但在半导体产业中扮演着越来越重要的角色。据市场研究数据,全球晶圆切割液市场在2024年的估值约为18.76亿美元,预计以4.87%的年复合增长率持续扩张。中国作为全球半导体消费的重要市场,2025年划片切割液国内市场规模约12.5亿元人民币,其中产品进口替代率已从2020年的35%提升至2025年的58%。

根据QYResearch报告出版商调研统计,2025年全球晶圆切割液市场销售额达到了97亿元,预计2032年将达到148.7亿元,年复合增长率(CAGR)为6.4%(2026-2032)。尽管各研究机构因统计口径和预测模型差异,具体数值有所不同,但均指向明确的增长趋势。
市场增长的背后,是三大驱动力的共同作用:一是AI、5G、物联网和新能源汽车对芯片需求的井喷;二是晶圆越来越薄、材料越来越硬(如碳化硅等第三代半导体),对切割液性能提出了更高要求;三是环保法规日益严格,推动切割液向无毒、低污染、可生物降解的方向加速迭代。
值得关注的是,随着Chiplet(芯粒)技术和先进封装的兴起,激光切割的应用比例正在快速提升,切割精度要求达到亚微米级别。激光切割工艺需要使用专门的水溶性高分子保护液,在晶圆表面形成耐温薄膜,防止切割产生的烧出物直接接触或再附着于晶圆表面。这意味着切割液也在从“通用型”走向“专用化”,针对不同工艺和材料开发定制配方。
趋势分析(数据来源于行业调研报告)
过去,传统的矿物油基切削液存在易燃、毒性、废液处理困难等环境隐患。如今,行业正加速向环保化方向转型。新一代切割液不再使用有毒有害原料,产品温和无刺激、可生物降解,废液容易处理。从行业趋势报告可以得出晶圆切割液未来趋势方向:
水基切割液将主导市场:环保优势(低VOC排放、易处理)使其在先进制程中更受青睐,预计2026年其在整体市场的占比将提升至65%。
迈向绿色环保配方:研发重点是开发无毒、无害、可生物降解的产品,满足日益严格的环保法规,这在全球半导体产业中越来越重要。
精准适配新材料与新工艺:随着碳化硅、氮化镓等第三代半导体材料的广泛应用,需要定制化切割液来应对其高硬度和高脆性特点。
生产迈向智能化:通过传感器实时监测切割液状态并动态调整,同时结合先进的过滤技术实现切割液的循环利用,是行业提升效率、降低成本的重要方向。
结语
从手机里的处理器,到汽车里的自动驾驶芯片,再到数据中心里的AI加速器——今天这个数字世界的每一个计算节点,都离不开半导体芯片。而在每一颗芯片诞生的背后,晶圆切割液都在默默履行着自己的职责:冷却、润滑、清洗、保护,以“隐形守护者”的身份,为精密制造保驾护航。看似只是一桶液体,实则凝聚了材料科学、表面化学和精密加工的多重智慧。

亦盛科技晶圆切割液
FQA(常见问题解答)
Q1:亦盛科技晶圆切割液适用于哪些材料和应用场景?
亦盛科技晶圆切割液为全合成高浓缩水基型产品,广泛应用于硅晶圆、碳化硅(SiC)、氮化镓(GaN)、蓝宝石、陶瓷基板等硬脆材料的刀轮切割、金刚石线切割及激光划切工艺(激光保护液系列)。尤其针对含铜互连层的先进制程晶圆及Low‑K介电层材料,能有效规避切割过程中的腐蚀、崩边、残留等行业痛点,适配集成电路、功率器件、LED衬底、先进封装等多领域生产需求。
Q2:稀释比例是多少?如何正确配制工作液?
我司晶圆切割液采用超高浓缩技术,推荐稀释比例为1:3000~10000(浓缩液:去离子水),具体结合产线调整,综合成本较常规切割液可降低40%以上。配制时务必使用去离子水,避免与其它化学品混用。
Q3:对刀片寿命和晶圆切割质量有什么影响?
我司产品采用专属极压润滑配方体系,在切割界面可快速形成纳米级防护润滑膜,有效降低摩擦系数,延长金刚石刀片寿命,减少刀片更换频率。同时,崩边尺寸可控制在≤8μm以内,降低切割后晶圆表面颗粒数,大幅提升切割良率。
Q4:泡沫多不多?会不会影响切割视觉监控?
我司产品采用专属低泡配方设计,高速切割时泡沫体积较少,无泡沫溢出,不遮挡切割视觉监控,保障晶圆切割精度。切割后晶圆表面无有机残留物,不影响后续清洗和封装工序。
Q5:是否环保?符合哪些认证标准?
我司晶圆切割液采用全合成水基配方,不含有毒有害、刺激性原料,产品环保温和、可生物降解,无危险,废液容易处理。同时,产品符合欧盟RoHS等环保法规要求,已通过多家国产头部半导体客户的验证。
Q6:能否兼容DISCO、东京精密等主流切割设备?
可以。我司晶圆切割液针对不同切割设备进行了配方优化,兼容DISCO、东京精密等主流划片设备,技术团队可深度参与客户产线调试,确保切割液与设备完美适配,减少工艺磨合时间。
Q7:是否支持定制化配方?
支持。针对不同晶圆材质(如硅、碳化硅、氮化镓)和切割工艺需求,我司可提供模块化配方调整,优化切割效率并降低刀具损耗,为客户提供定制化解决方案。